QR kodas

Apie mus
Produktai
Susisiekite su mumis

Telefonas

Faksas
+86-579-87223657

paštas

Adresas
Wangda Road, Ziyang gatvė, Wuyi apskritis, Jinhua miestas, Džedziango provincija, Kinija
Silicio epitaksijayra esminis pagrindinis šiuolaikinės puslaidininkių gamybos procesas. Tai reiškia, kad ant tiksliai poliruoto monokristalinio silicio pagrindo auginamas vienas ar daugiau plonų vienakristalinių silicio plėvelių sluoksnių, turinčių specifinę kristalų struktūrą, storį, dopingo koncentraciją ir tipą. Ši išaugusi plėvelė vadinama epitaksiniu sluoksniu (Epitaxial Layer arba Epi Layer), o silicio plokštelė su epitaksiniu sluoksniu vadinama epitaksine silicio plokštele. Pagrindinė jo savybė yra ta, kad naujai užaugintas epitaksinis silicio sluoksnis yra substrato gardelės struktūros tęsinys kristalografijoje, išlaikant tą pačią kristalų orientaciją kaip ir substratas, sudarydamas tobulą vieno kristalo struktūrą. Tai leidžia epitaksiniam sluoksniui turėti tiksliai suprojektuotas elektrines savybes, kurios skiriasi nuo pagrindo savybių, todėl yra pagrindas gaminti aukštos kokybės puslaidininkinius įtaisus.
![]()
Vertikalusis epitaksinis susceptorius, skirtas silicio epitaksijai
1) Apibrėžimas: Silicio epitaksija – tai technologija, kuri cheminiais arba fiziniais metodais nusodina silicio atomus ant vienkristalinio silicio substrato ir sutvarko juos pagal substrato gardelės struktūrą, kad išaugtų nauja vieno kristalo silicio plona plėvelė.
2) Grotelių atitikimas: Pagrindinis bruožas yra epitaksinio augimo tvarkingumas. Nusodinti silicio atomai nėra sukrauti atsitiktinai, o yra išdėstyti pagal substrato kristalinę orientaciją, vadovaujantis „šablonu“, kurį suteikia substrato paviršiuje esantys atomai, taip pasiekiant tikslią replikaciją atominiu lygiu. Tai užtikrina, kad epitaksinis sluoksnis yra aukštos kokybės monokristalas, o ne polikristalinis ar amorfinis.
3) Valdomumas: Silicio epitaksijos procesas leidžia tiksliai kontroliuoti augimo sluoksnio storį (nuo nanometrų iki mikrometrų), dopingo tipą (N tipo arba P tipo) ir dopingo koncentraciją. Tai leidžia ant tos pačios silicio plokštelės suformuoti skirtingų elektrinių savybių regionus, o tai yra sudėtingų integrinių grandynų gamybos pagrindas.
4) Sąsajos charakteristikos: tarp epitaksinio sluoksnio ir substrato susidaro sąsaja. Idealiu atveju ši sąsaja yra atomiškai plokščia ir neužteršta. Tačiau sąsajos kokybė yra labai svarbi epitaksinio sluoksnio veikimui, o bet kokie defektai ar užterštumas gali turėti įtakos galutiniam įrenginio veikimui.
Silicio epitaksinis augimas daugiausia priklauso nuo tinkamos energijos ir aplinkos suteikimo silicio atomams migruoti ant pagrindo paviršiaus ir rasti mažiausią energijos gardelės padėtį derinimui. Šiuo metu dažniausiai naudojama technologija yra cheminis nusodinimas iš garų (CVD).
Cheminis nusodinimas iš garų (CVD): tai pagrindinis metodas silicio epitaksijai pasiekti. Pagrindiniai jo principai yra šie:
● Pirmtakų transportavimas: Dujos, kurių sudėtyje yra silicio elemento (pirmtako), pvz., silanas (SiH4), dichlorsilanas (SiH2Cl2) arba trichlorsilanas (SiHCl3), ir dopingo dujos (pvz., fosfinas PH3, skirtas N tipo legiravimui, ir diboranas B2H6, skirtas P tipo legiravimui), sumaišomos į tikslią kamerą ir temperatūrą.
● Paviršiaus reakcija: Esant aukštai temperatūrai (dažniausiai tarp 900°C ir 1200°C), šios dujos chemiškai skaidosi arba reaguoja į įkaitinto silicio pagrindo paviršių. Pavyzdžiui, SiH4→Si(kietas)+2H2(dujos).
● Paviršiaus migracija ir branduolių susidarymas: Skilimo metu susidarę silicio atomai adsorbuojami į substrato paviršių ir migruoja ant paviršiaus, galų gale suranda tinkamą gardelės vietą, kuri gali susijungti ir pradėti formuoti naują vienąkristalo sluoksnis. Epitaksinio augimo silicio kokybė labai priklauso nuo šio žingsnio kontrolės.
● Sluoksniuotas augimas: Naujai nusodintas atominis sluoksnis nuolat kartoja pagrindo gardelės struktūrą, auga sluoksnis po sluoksnio ir sudaro tam tikro storio epitaksinį silicio sluoksnį.
Pagrindiniai proceso parametrai: Silicio epitaksijos proceso kokybė yra griežtai kontroliuojama, o pagrindiniai parametrai apima:
● Temperatūra: veikia reakcijos greitį, paviršiaus judrumą ir defektų susidarymą.
● Slėgis: veikia dujų transportavimą ir reakcijos kelią.
● Dujų srautas ir santykis: nustato augimo greitį ir dopingo koncentraciją.
● Pagrindo paviršiaus švara: Bet koks teršalas gali būti defektų priežastis.
● Kitos technologijos: Nors CVD yra pagrindinė kryptis, tokios technologijos kaip MBE (Molecular Beam Epitaxy) taip pat gali būti naudojamos silicio epitaksijai, ypač MTTP arba specialiose programose, kurioms reikalingas itin didelis tikslumas.MBE tiesiogiai išgarina silicio šaltinius itin didelio vakuumo aplinkoje, o atominiai arba molekuliniai pluoštai yra tiesiogiai projektuojami ant substrato augimui.
Silicio epitaksijos technologija labai išplėtė silicio medžiagų pritaikymo spektrą ir yra nepakeičiama daugelio pažangių puslaidininkinių prietaisų gamybos dalis.
● CMOS technologija: Didelio našumo loginiuose lustuose (pvz., CPU ir GPU) mažai legiruotas (P− arba N−) epitaksinis silicio sluoksnis dažnai auginamas ant stipriai legiruoto (P+ arba N+) pagrindo. Ši epitaksinė silicio plokštelės struktūra gali veiksmingai slopinti fiksavimo efektą (užraktą), pagerinti įrenginio patikimumą ir išlaikyti žemą pagrindo atsparumą, kuris yra palankus srovės laidumui ir šilumos išsklaidymui.
● Bipoliniai tranzistoriai (BJT) ir BiCMOS: Šiuose įrenginiuose silicio epitaksė naudojama tiksliai sukonstruoti tokias struktūras kaip bazė arba kolektoriaus sritis, o stiprinimas, greitis ir kitos tranzistoriaus charakteristikos optimizuojamos kontroliuojant dopingo koncentraciją ir epitaksinio sluoksnio storį.
● Vaizdo jutiklis (CIS): Kai kuriose vaizdo jutiklių programose epitaksinės silicio plokštelės gali pagerinti pikselių elektrinę izoliaciją, sumažinti skersinį pokalbį ir optimizuoti fotoelektrinės konversijos efektyvumą. Epitaksinis sluoksnis suteikia švaresnę ir mažiau defektuotą aktyvią sritį.
● Išplėstiniai proceso mazgai: Kadangi įrenginio dydis ir toliau mažėja, reikalavimai medžiagų savybėms tampa vis aukštesni. Silicio epitaksijos technologija, įskaitant selektyvų epitaksinį augimą (SEG), naudojama įtemptiems silicio arba silicio germanio (SiGe) epitaksiniams sluoksniams auginti konkrečiose srityse, siekiant pagerinti nešiklio mobilumą ir taip padidinti tranzistorių greitį.
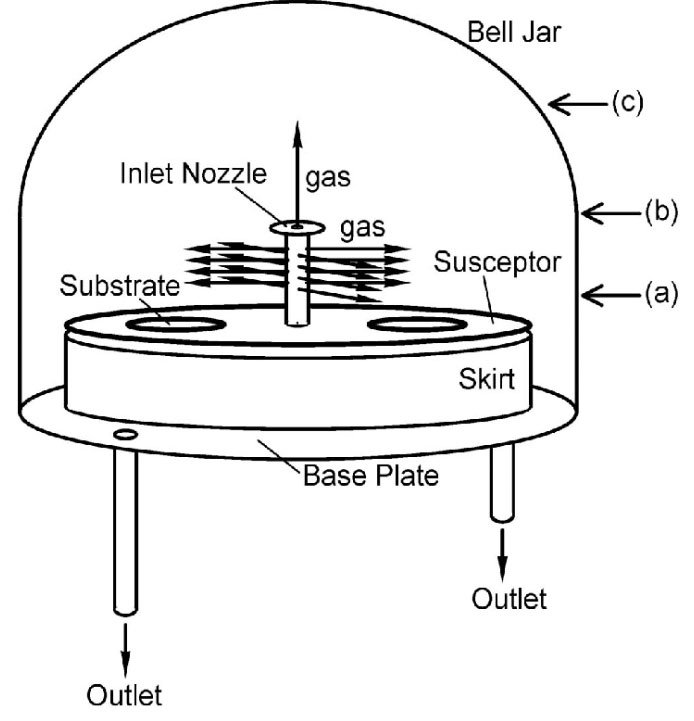
Horizontalus epitaksinis susceptorius, skirtas silicio epitaksijai
Nors silicio epitaksijos technologija yra brandi ir plačiai naudojama, vis dar yra tam tikrų iššūkių ir problemų, susijusių su silicio proceso epitaksiniu augimu:
● Defektų kontrolė: Epitaksinio augimo metu gali atsirasti įvairių kristalų defektų, pvz., sudėjimo defektai, išnirimai, slydimo linijos ir kt. Šie defektai gali rimtai paveikti įrenginio elektrinį veikimą, patikimumą ir našumą. Defektams kontroliuoti reikalinga itin švari aplinka, optimizuoti proceso parametrai ir aukštos kokybės substratai.
● Vienodumas: Siekti tobulo epitaksinio sluoksnio storio ir dopingo koncentracijos vienodo didelio dydžio silicio plokštelėse (pvz., 300 mm) yra nuolatinis iššūkis. Nevienodumas gali lemti įrenginio veikimo skirtumus toje pačioje plokštelėje.
● Autodopingas: Epitaksinio augimo proceso metu didelės koncentracijos priedai substrate gali patekti į augantį epitaksinį sluoksnį per dujų fazės difuziją arba kietojo kūno difuziją, todėl epitaksinio sluoksnio dopingo koncentracija nukrypsta nuo numatomos vertės, ypač šalia epitaksinio sluoksnio ir substrato sąsajos. Tai viena iš problemų, kurią reikia išspręsti silicio epitaksijos procese.
● Paviršiaus morfologija: epitaksinio sluoksnio paviršius turi išlikti labai plokščias, o bet koks šiurkštumas ar paviršiaus defektai (pvz., migla) turės įtakos tolesniems procesams, pvz., litografijai.
● Kaina: Palyginti su įprastomis poliruoto silicio plokštelėmis, gaminant epitaksines silicio plokšteles prideda papildomų proceso etapų ir investicijų į įrangą, todėl išlaidos yra didesnės.
● Atrankinės epitaksijos iššūkiai: Pažangiuose procesuose selektyvus epitaksinis augimas (augimas tik tam tikrose srityse) kelia didesnius proceso valdymo reikalavimus, tokius kaip augimo greičio selektyvumas, šoninio peraugimo kontrolė ir kt.
Kaip pagrindinė puslaidininkinių medžiagų paruošimo technologija, pagrindinė savybėsilicio epitaksijayra galimybė tiksliai išauginti aukštos kokybės monokristalinio epitaksinio silicio sluoksnius su specifinėmis elektrinėmis ir fizinėmis savybėmis ant vieno kristalo silicio substratų. Tiksliai valdant parametrus, tokius kaip temperatūra, slėgis ir oro srautas silicio epitaksijos procese, sluoksnio storis ir dopingo pasiskirstymas gali būti pritaikyti, kad atitiktų įvairių puslaidininkių programų, tokių kaip CMOS, maitinimo įtaisai ir jutikliai, poreikius.
Nors epitaksinis silicio augimas susiduria su tokiais iššūkiais kaip defektų kontrolė, vienodumas, savaiminis dopingas ir kaina, nuolat tobulėjant technologijoms, silicio epitaksija vis dar yra viena iš pagrindinių varomųjų jėgų, skatinančių puslaidininkinių prietaisų veikimą ir funkcines naujoves, o jos padėtis epitaksinių silicio plokštelių gamyboje yra nepakeičiama.



+86-579-87223657


Wangda Road, Ziyang gatvė, Wuyi apskritis, Jinhua miestas, Džedziango provincija, Kinija
Autoriaus teisės © 2024 VeTek Semiconductor Technology Co., Ltd. Visos teisės saugomos.
Links | Sitemap | RSS | XML | Privacy Policy |
