QR kodas

Produktai
Susisiekite su mumis

Telefonas

Faksas
+86-579-87223657

paštas

Adresas
Wangda Road, Ziyang gatvė, Wuyi apskritis, Jinhua miestas, Džedziango provincija, Kinija
Puslaidininkių gamybojeCheminis mechaninis planavimas (CMP)procesas yra pagrindinis etapas, skirtas plokštelės paviršiaus planavimui pasiekti, tiesiogiai nulemdamas vėlesnių litografijos etapų sėkmę ar nesėkmę. Poliravimo suspensijos, kaip svarbiausios CMP vartojimo medžiagos, efektyvumas yra pagrindinis veiksnys kontroliuojant pašalinimo greitį (RR), sumažinant defektus ir didinant bendrą išeigą.
Šiame vadove pateikiama sisteminė CMP srutų techninės sistemos analizė ir nagrinėjama, kaip išlaikyti proceso stabilumą sudėtingoje gamybos aplinkoje, kad būtų sumažintos sąnaudos ir padidėtų efektyvumas.

I. Tipinė CMP srutų sudėtis
Tipiška CMP suspensija yra cheminio poveikio ir fizinės mechaninės jėgos sinergetinis produktas, susidedantis iš šių pirminių komponentų:
Abrazyvai: suteikia mechaninio pašalinimo galimybes. Įprasti tipai yra nano dydžio silicio dioksidas, cerija ir aliuminio oksidas.
Oksidatoriai: padidinkite cheminių reakcijų greitį oksiduodami metalinį paviršių; įprasti pavyzdžiai yra H2O2 arba geležies druskos.
Chelatiniai agentai: sudaro kompleksus su metalo jonais, kad palengvintų tirpimą.
Korozijos inhibitoriai: pagerinkite medžiagų selektyvumą slopindami koroziją netikslinėse srityse.
Priedai: įtraukite pH reguliatorius ir dispergentus, naudojamus reakcijos langui ir sistemos stabilumui palaikyti.
Cheminės ir fizinės srutų savybės turi būti tiksliai suderintos su tikslinės medžiagos savybėmis; kitu atveju atsiras defektų, tokių kaip įbrėžimai, išblukimas ir korozija.①
II. Srutų sistemos įvairioms medžiagoms
Kadangi įvairių vaflių medžiagų savybėsplėvelės sluoksniai labai skiriasi, suspensijos turi būti pritaikytos ir nukreiptos:
|
Tikslinės medžiagos tipas |
Įprastas srutų tipas |
Pagrindinės charakteristikos |
|
Silicio dioksidas (SiO₂) |
Koloidinės silicio dioksido srutos |
Vidutinis pašalinimo greitis su dideliu selektyvumu |
|
Varis (Cu) |
Sudėtinė sistema su oksidatoriais / chelatoriais / inhibitoriais |
Atsparus korozijai; pirmiausia lemia cheminė kontrolė |
|
Volframas (W) |
Geležies druska + Abrazyvinis derinys |
Reikia slopinti koroziją ir susidėvėjimą; siauras proceso langas |
|
Tantalo / tantalo nitridas (Ta / TaN) |
Didelio selektyvumo srutos, dažnai dalijamos su Cu |
Paprastai suporuotas su vario procesais; itin aukšti defektų kontrolės reikalavimai |
|
Mažos k medžiagos |
Cheminio poliravimo sistema be abrazyvinių medžiagų |
Apsaugo nuo mikro įtrūkimų; didelė plėvelės lūžimo rizika |
III. Pagrindinės našumo metrikos
Vertinant efektyvumo didinimo galimybes, labai svarbūs šie techniniai rodikliai:
Pašalinimo greitis (RR): per laiko vienetą pašalintos medžiagos storis (nm/min), kuris tiesiogiai veikia fab pralaidumą.
Selektyvumas: tikslinės medžiagos ir gretimų medžiagų pašalinimo greičio santykis; didesnis selektyvumas geriau apsaugo netikslinius sluoksnius.
„In-Wafer Non-Uniformity“ (WIWNU): matuoja plokštelės paviršiaus plokštumos nuoseklumą.
Defektas: apima kritinius derliaus mažinimo rodiklius, tokius kaip įbrėžimai ir mikrodalelių likučiai. Srutų stabilumas: srutų gebėjimas atsispirti sluoksniavimuisi, aglomeracijai arba nuosėdoms sandėliuojant ir naudojant.
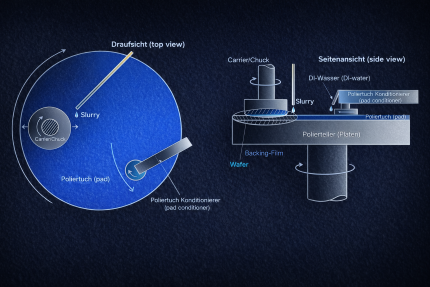
IV. Pramonės geriausia praktika procesų stabilumui gerinti
Siekdamos ilgalaikio „išlaidų mažinimo ir efektyvumo didinimo“, pirmaujančios puslaidininkių įmonės daugiausia dėmesio skiria tokiai stabilumo valdymo praktikai:
Tikslus cheminių ir mechaninių jėgų balansas: Tiksliai sureguliavus abrazyvų ir cheminių komponentų santykį, reakcijos pusiausvyra palaikoma molekuliniame lygmenyje, sumažinant indų defektus šaltinyje.
Skysčių stabilumas ir filtravimo valdymas: Griežta pH svyravimų kontrolė srutų cirkuliacijos sistemoje kartu su didelio efektyvumo filtravimo technologija apsaugo nuo įbrėžimų lakumo, kurį sukelia dalelių aglomeracija.
Pritaikytas procesų suderinimas: tam tikros suspensijos yra sukurtos skirtingam fiziniam kietumui (pvz., didelio kietumo SiC arba trapioms mažo k medžiagų kiekio medžiagoms), kad būtų maksimaliai padidintas proceso langas.
Nuoseklumo stebėjimo standartai: Griežtos partijų kontrolės strategijos sukūrimas užtikrina, kad pagrindinės metrikos, tokios kaip RR ir WIWNU, išliks nuoseklios masinės gamybos metu.
Aautorius:Sera-Lee
Nuoroda:
①CMP srutų pasirinkimas: medžiagų perspektyva – AZoM
②Cheminės mechaninės planarizacijos srutų chemijos apžvalga – Entegris



+86-579-87223657


Wangda Road, Ziyang gatvė, Wuyi apskritis, Jinhua miestas, Džedziango provincija, Kinija
Autoriaus teisės © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Visos teisės saugomos.
Links | Sitemap | RSS | XML | Privatumo politika |
